2023年,受到下游需求不景气以及地缘政治等因素影响,全球半导体产业陷入下滑周期,相关供应链面临多重挑战。
2024年,半导体产业链的各个环节都在期待一场“复苏”,确实经过周期性调整,消费电子、存储、被动器件等多个领域“筑底”已基本完成,并出现结构性回暖迹象。
根据IDC 2024年的最新报告显示,预测2024 年半导体市场将增长 20%,其主要驱动力来自内存回升和全行业库存调整解决方案。从长远来看,由于产业转向AI、计算机基础建设、汽车、HBM 和小芯片,2029年全球半导体产值将接近1万亿美元。

图 | 半导体市场预测,来源:IDC 2024,亚智科技
AI拉动算力需求,先进封装乘势而起
在AI、HPC产业发展的催化下,先进封装乘势而起,封装技术从二维转向三维,从最初的封装元件转向封装系统。
提到先进封装就不得不提到RDL(Redistribution Layer,重布线层),而RDL在大部分场景下的目的都是Fan Out (扇出),以实现更轻薄、更多的IO接口、更好的电性能。
根据Yole 2022年12月发布的数据显示,全球扇出型封装产值预计将在2028年达到38亿美元, 2022-2028年复合年增长率为12.5%。其中,FOPLP(扇出型板级封装)占据了整个扇出型封装市场约5-10%的市场,并且未来几年还将不断增长。

图 | 全球扇出型封装市场规模,来源:Yole,亚智科技
虽然,在扇出型封装技术中,FOWLP(扇出型晶圆级封装)依旧是主流,但未来随着芯片越做越大,比如英伟达最新发布的B200就有半个巴掌大,FOWLP小于85%的面积使用率就成了短板,单位晶圆可放置的芯片数量远小于FOPLP。因此,在产品面世时间和成本的多维度考量下,芯片设计和制造企业在封装技术的选择上,正在逐渐由FOWLP部分转向FOPLP。
根据Manz集团亚洲区总经理林峻生的介绍,目前半导体OSAT(外包半导体组装测试厂商)、IDM(集成器件制造商)、晶圆代工厂(Foundry)、PCB厂、载板厂和面板厂都在试图从FOPLP技术中寻求机遇,并进行了相应投资。但相对来说,IDM对自己的产品规格是自主可控的,他可以进行快速尝试,并得出与传统封装的产品单价成本对比结论,当看到可以切切实实地降低成本后,就会持续投入,一旦起量,成本优势相当可观,所以IDM是是推进速度最快的。
RDL先进制程正在加速全球板级封装部署和生产
前面提到RDL是扇出型封装的核心,因此得到了业界普遍的关注。那么到底什么是重布线制程呢?
RDL重布线层是将原设计的IC线路接点位置(I/O pad),透过晶圆级金属布线制程和凸块制程来改变其接点位置,使IC能应用于不同的元件模组。
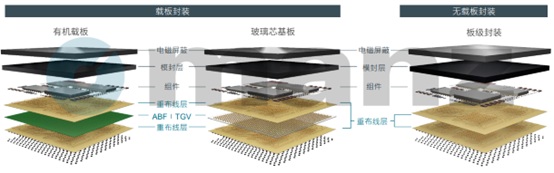
图 | 板级重布线层工艺应用示意,来源:亚智科技
而对于板级封装来讲,RDL的概念也是类似的,它的作用是改变线路I/O原有设计,增加原有设计的附加价值,加大I/O的间距,提供较大的凸块面积,降低基板与元件间的应力,增加元件的可靠性,同时RDL还可以取代部分IC线路设计,加速IC开发进程。不过相比晶圆级封装RDL,板级封装RDL则是把原来在晶圆上的重布线工作放到了IC载板上。
不过值得一提的是,未来FOPLP若全面走向RDL First,需要的RDL是非常精密的,包括如何形成高膜厚均匀性且高分辨率的RDL层,铜互联要实现微纳或者纳米级别的组织调控,采用自由取向的再布线技术等都存在较高的挑战。
TGV正在重塑IC载板市场格局
伴随着于人工智能、5G和汽车领域的需求高增长,全球IC载板市场规模正在不断扩大。根据Preismark和Yole 2023年发布的数据显示,预测2023-2027年全球IC载板市场规模年复合增长率将达到11.94%。

图 | 全球IC载板市场规模,来源:Preismark,Yole,亚智科技
提到IC载板,就不得不提一下近期的热点,英特尔于 2023 年 9 月 19 日宣布推出业界首款用于下一代先进封装的玻璃基板,并计划在2026-2030年间量产,被导入到需要较大封装体积的数据中心、AI及绘图处理等相关应用,让以玻璃基板封装的高运算芯片效能得以全力发挥。
这一计划的宣布直接引爆了业界对TGV的关注。那么,什么是TGV呢?
TGV(Through Glass Via)中文译为玻璃通孔,即穿过玻璃基板的垂直电气互连。TGV 以高品质硼硅玻璃、石英玻璃为基材,通过种子层溅射、电镀填充、化学机械平坦化、RDL再布线,bump工艺引出实现2.5D/3D互联,因此被视为下一代先进封裝集成的关键技术。
对此,Manz集团亚洲区研发部协理李裕正博士表示:“与传统的有机基板相比,玻璃具有独特的性能,例如玻璃基板具备超高平坦度、更佳的电气性能、更高散热性和更佳的尺寸稳定性,有望进一步提高基板互连密度。同时,TGV为昂贵的硅技术提供了一种成本更低、 电气损耗更低的替代方案。不过,当前TGV主要是用作先进载板结构之玻璃芯,暂时还没有成熟的工艺来用TGV替代中介层,虽然未来不是没有可能,但还有很长的路要走。”

图 | 玻璃芯 VS 玻璃中介层,来源:亚智科技
从市场应用机会來看,TGV将会先导入先进载板中之玻璃芯结构,以用于AI、HPC、HF RF、IPD等领域。此外,TGV的先进载板虽然具有众多优点,初期将部分取代IC载板市场,但在成本上暂时还是相对较高的,所以未来很长时间内都会与传统有机基板共存,市场相互补充。
FOPLP封装发展升级,需要高效的生产设备
FOPLP封装技术的发展升级,离不开RDL制程,而精密的RDL与半导体制造企业所使用的生产设备和工艺关联度很大。
在2024 Semicon China展会上,我们看到Manz亚智科技(后面简称“亚智科技”)正在扩大RDL 研发版图。
众所周知,亚智科技在化学湿制程(洗净、蚀刻、通孔工艺设备)、自动化及电镀等生产设备解决方案领域已经深耕近40年,并为全球十大载板厂及面板厂提供稳定量产的有力支持。近年来,随着半导体产业的茁壮成长,基于在有机材料上发展的RDL技术,以及多年在传输玻璃载板领域的经验,亚智科技又进军半导体产业,在推进全球板级封装的部署和生产方面贡献不少。
对此,Manz 集团亚洲区销售副总经理简伟铨表示:“Manz RDL 制程设备解决方案可无缝整合化学湿制程工艺前后制程,并确保电镀后的基板表面均匀性最高可达95%,铜厚度超过 100 μm。 这不仅提高了芯片密度,还改善了散热性。”

图 | Manz 电镀设备可依据客户制程需求,实现单、双面电镀,加速产速,来源:亚智科技
具体来讲,Manz RDL 制程设备解决方案具有以下特色:
- 电镀设备并支持高达10 ASD的高电镀电流密度,提高整体制造能力。
- 新型的垂直电镀铜无需使用治具,透过专利的整机设计即可完成单面电镀铜制程,可节省治具的购置与维护成本,还能实时监控制程中的电镀药水成分,确保制程的稳定与高效。
- 多分区阳极设计,提升电镀均匀性达95 %,线宽线距最小达到5μm / 5 μm。
此外,针对高深宽比需求,Manz RDL制程设备可完整完成清洗、蚀刻、通孔以及电镀填孔的工艺任务,搭配自动化设备,可提供整合度高的玻璃芯基材解决方案,达成大于100um的高真圆度通孔,优化器件电力与讯号传输,提升芯片效能。




















 3394
3394

 下载ECAD模型
下载ECAD模型











